Rasterkraftmikroskopie
Rasterkraftmikroskopie (AFM) ist eine hochauflösende Bildgebungstechnik zur Analyse der Oberflächentopographie und Materialeigenschaften mit einer Auflösung im Sub-Nanometerbereich. Die Technik ermöglicht die Untersuchung verschiedener Materialeigenschaften wie Oberflächenrauheit, topologische Merkmale, Oberflächendefekte sowie mechanische und elektromagnetische Eigenschaften des Materials und eignet sich ideal für die Analyse von Dünnschichten, Nanopartikeln und organischen Materialien.
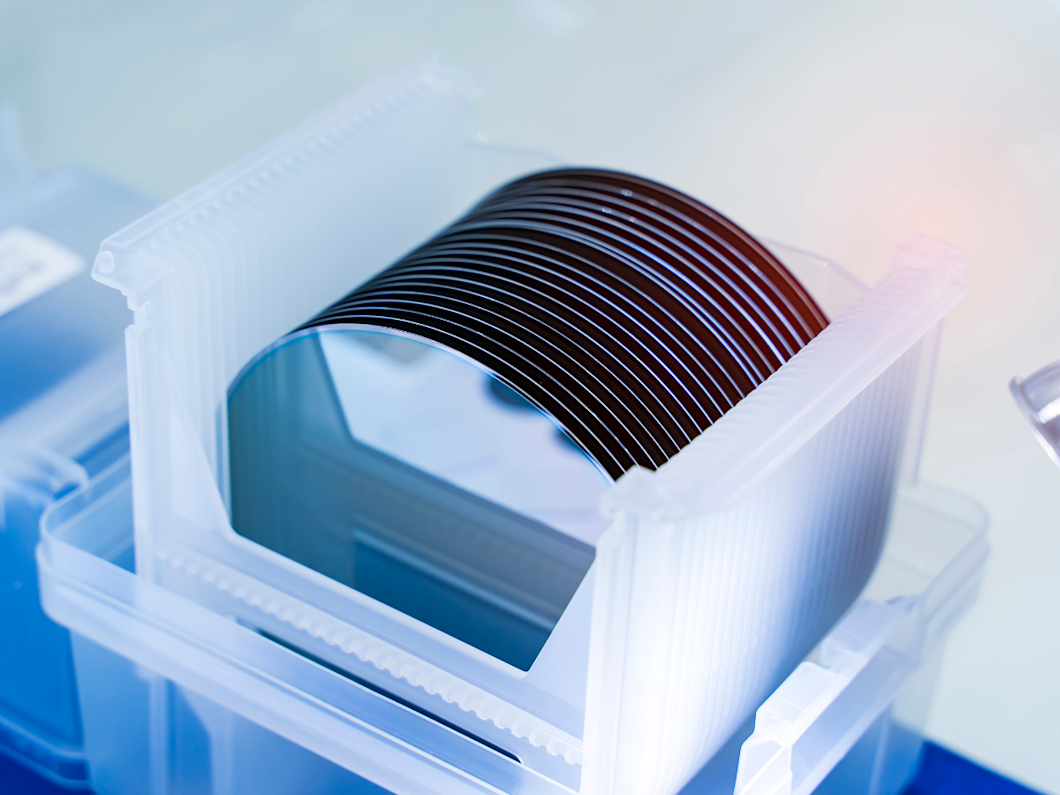
Einige unserer AFM-Dienstleistungen
AFM-Oberflächenrauheitsmessung
AFM-Oberflächenabbildung
Preise ohne MwSt.
Wofür wird die AFM-Analyse verwendet?
AFM ist eine weit verbreitete Charakterisierungstechnik, die eine hochauflösende, dreidimensionale Abbildung der Probenoberfläche mit einer Auflösung im Sub-Nanometerbereich ermöglicht. Dies macht AFM ideal für die Analyse von Merkmalen im Nanomaßstab wie Oberflächenrauheit, topologischen Merkmalen und Oberflächendefekten. Neben der Topographie kann AFM durch spezialisierte Modi auch lokale mechanische und elektromagnetische Eigenschaften wie Steifigkeit, Adhäsion, Leitfähigkeit, Oberflächenpotential und magnetische Domänen abbilden.
Die AFM eignet sich für eine Vielzahl von Materialien, darunter Halbleiter, Dünnschichten, Nanomaterialien, Metalle, Polymere und biologische Proben. Sie ist besonders wertvoll für die Charakterisierung von Dünnschichten, die durch Verfahren wie Chemical Vapor Deposition (CVD), Atomic Layer Deposition (ALD), Physical Vapor Deposition (PVD) und Spin Coating abgeschieden wurden. Im Gegensatz zu vielen anderen Oberflächenanalyseverfahren benötigt die AFM weder ein Vakuum noch leitfähige Proben. Sie kann auch in Luft, Vakuum oder Flüssigkeiten durchgeführt werden, was die Analyse einer Vielzahl von Materialien ermöglicht.
Beispielsweise ermöglicht uns die AFM die Analyse der Oberflächenrauheit von dünnen Schichten, die bei unterschiedlichen Temperaturen verarbeitet wurden. Aus den resultierenden 2D- und 3D-Oberflächenkarten können quantitative Daten wie die mittlere quadratische Rauheit (RMS) oder die Höhenverteilung der Merkmale extrahiert werden.

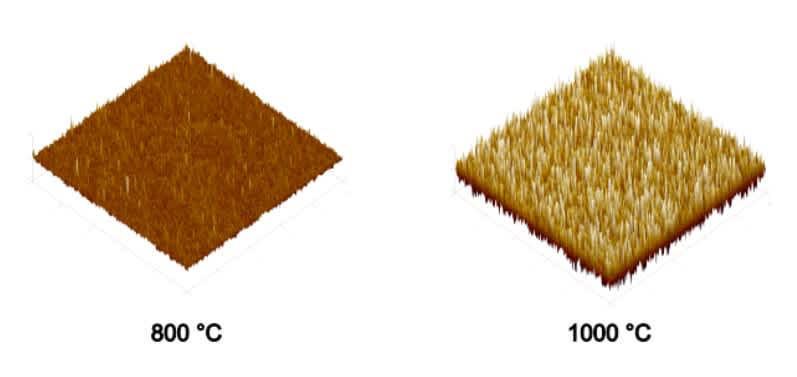
Grenzen und alternative Techniken
Die AFM ist zwar ein äußerst vielseitiges und präzises Werkzeug, dennoch sind ihre Fähigkeiten durch die Abbildungsbedingungen begrenzt. Die AFM kann Merkmale mit einer maximalen Höhe von 20 µm und Bereiche bis zu 100 × 100 µm abbilden. Für größere Merkmale oder größere Bereiche empfehlen wir die Profilometrie. Die AFM-Analyse ist außerdem am genauesten auf sauberen und ebenen Oberflächen, während sehr raue oder ungewöhnlich geformte Oberflächen schwierig zu analysieren sind. Bei ordnungsgemäßer Optimierung liefert die AFM jedoch wertvolle Daten zu Oberflächeneigenschaften, die für die Produktentwicklung, Qualitätskontrolle und Prozessoptimierung von wesentlicher Bedeutung sind.

Wie funktioniert die Rasterkraftmikroskopie?
AFM arbeitet, indem eine scharfe Spitze, die auf einem flexiblen Cantilever montiert ist, über die Probenoberfläche gescannt wird. Während die Sonde die Probenoberfläche scannt, führen Wechselwirkungen zwischen der Spitze und der Probe zu einer Biegung des Cantilevers. Ein Laserstrahl wird vom Cantilever reflektiert, verfolgt diese Auslenkungen mit hoher Präzision und zeichnet Änderungen in der Position der Spitze auf. Die aufgezeichneten Laserauslenkungen werden verwendet, um eine Karte der Probenoberfläche zu rekonstruieren.
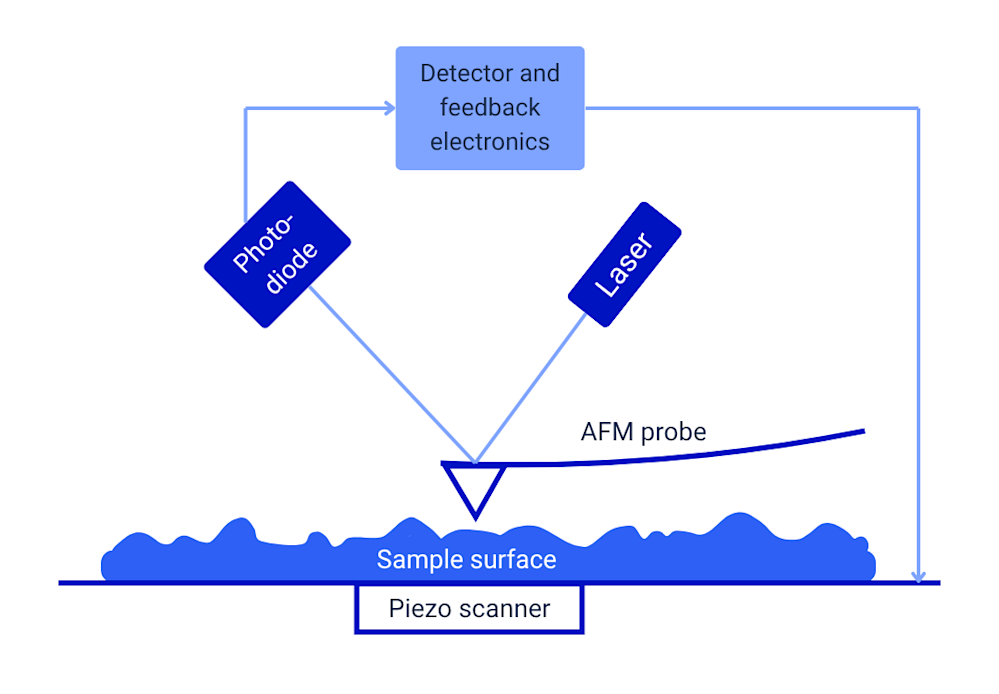
AFM-Modi
Die AFM kann in drei verschiedenen Modi erfolgen: Kontaktmodus, Tapping-Modus und kontaktloser Modus. Jeder Modus bietet eigene Vorteile und eignet sich für unterschiedliche Probentypen und Messungen.
Kontaktmodus: Die Spitze bleibt während des Scannens in kontinuierlichem Kontakt mit der Probenoberfläche. Der Kontaktmodus bietet hohe Auflösung und schnelle Bildgebung, übt jedoch eine konstante Kraft auf die Probe aus, was die Probenoberfläche beschädigen kann. Er eignet sich am besten für harte, glatte Oberflächen wie Wafer oder dünne Schichten.
Tapping-Modus: Dies ist einer der am häufigsten verwendeten Modi. Im Tapping-Modus schwingt der Cantilever so, dass die Spitze bei jedem Zyklus kurz die Oberfläche berührt. Dadurch wird der Druck reduziert, der weiche oder locker gebundene Oberflächen beschädigen kann, während gleichzeitig eine hohe Auflösung beibehalten wird. Der Tapping-Modus eignet sich ideal für eine Vielzahl von Materialien, darunter Polymere, Verbundwerkstoffe und biologische Proben.
Kontaktloser Modus: Der Cantilever schwingt knapp über der Probenoberfläche, ohne physischen Kontakt herzustellen. Die Spitze erfasst langreichweitige Anziehungskräfte (van der Waals), die die Schwingungsamplitude und -frequenz geringfügig verändern. Dieser Modus ist sehr schonend und besonders nützlich für weiche, empfindliche oder kontaminationsanfällige Oberflächen. Er bietet jedoch typischerweise eine geringere Auflösung als der Tapping- oder Kontaktmodus und ist empfindlicher gegenüber Umgebungsrauschen und Kontamination.
Benötigen Sie AFM-Analysen?
Measurlabs führt routinemäßig AFM-Messungen für mehrere große Kunden in der Halbleiterindustrie durch. Einer davon ist Okmetic, der siebtgrößte Siliziumwafer-Hersteller der Welt. Lesen Sie hier mehr über unsere Zusammenarbeit:
Wenn Sie AFM-Dienstleistungen für Dünnschichten oder andere Beschichtungen suchen, helfen wir Ihnen gerne weiter. Über AFM hinaus bieten wir ein umfassendes Spektrum fortschrittlicher Techniken zur Charakterisierung von Dünnschichten und Halbleitern an, sodass Sie alle benötigten Erkenntnisse über einen einzigen Ansprechpartner erhalten können. Nutzen Sie das untenstehende Formular, um uns Ihre Testanforderungen mitzuteilen, und wir werden uns in Kürze bei Ihnen melden.
Methodenexperte
Passende Probenmatrizen
- Blankowafers, wie Silizium (Si), Siliziumoxid (SiO2), Siliziumkarbid (SiC), Galliumnitrid (GaN), Galliumarsenid (GaAs) und Indiumphosphid (InP)
- PVD-, CVD- und ALD-Dünnschichten
- Nanostrukturierte Oberflaechen
- Nanopartikel
- Polymere und organische Materialien
- Metalle und Legierungen
Ideale Anwendungen der AFM
- Hochauflösende Abbildung der Oberflächentopografie
- Quantitative Messungen der Oberflächenrauheit und von Dickensstufen
- Charakterisierung von Nanostrukturen, Körnern und Oberflächenfehlern
- Kartierung mechanischer Eigenschaften wie Steifigkeit, Adhäsion und Elastizität
- Qualitätskontrolle und vergleichende Analyse von dünnen Filmschichten
Fragen Sie nach einem Angebot
Füllen Sie das Formular aus und wir antworten Ihnen innerhalb eines Werktages.
Haben Sie Fragen oder brauchen Hilfe? Schreiben Sie uns unter info@measurlabs.com oder rufen Sie unser Vertriebsteam an.
Häufig gestellte Fragen
Measurlabs bietet eine Vielzahl von Laboranalysen für Produktentwickler und Qualitätsmanager an. Einige der Analysen führen wir in unserem eigenen Labor durch, die meisten lagern wir jedoch an sorgfältig ausgewählte Partnerlabore aus. Auf diese Weise können wir jede Probe an das am besten geeignete Labor senden und unseren Kunden hochwertige Analysen mit mehr als tausend verschiedenen Methoden anbieten.
Wenn Sie uns über unser Kontaktformular oder per E-Mail kontaktieren, übernimmt einer unserer Spezialisten Ihren Fall und beantwortet Ihre Anfrage. Sie erhalten ein Angebot mit allen notwendigen Details zur Analyse und können Ihre Proben an die angegebene Adresse senden. Wir kümmern uns dann darum, Ihre Proben an die richtigen Labore weiterzuleiten, und erstellen einen übersichtlichen Bericht über die Ergebnisse für Sie.
Proben werden in der Regel per Kurier an unser Labor geliefert. Kontaktieren Sie uns für weitere Details, bevor Sie Proben einsenden.
